【更小、更薄】華進TSV封裝為指紋模組帶來革新
2016/04/13
華進成功將直孔TSV的工藝應用到指紋識別芯片晶圓級封裝,并與客戶一起推出封裝完成的芯片與模組。與蘋果等廠商基于Trench + Wire Bonding的封裝制程不同, 直孔TSV封裝為指紋模組的可制造性帶來革命性優勢,減小模組尺寸,模組良率大幅提高,更適合手機工業的需求,以及滿足下一代產品的新興需求(更薄、更小、簡化模組)。
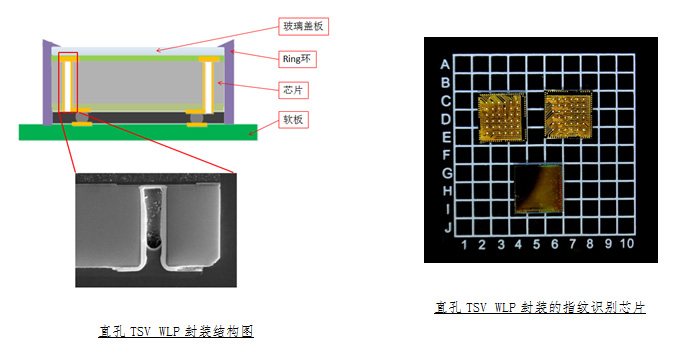
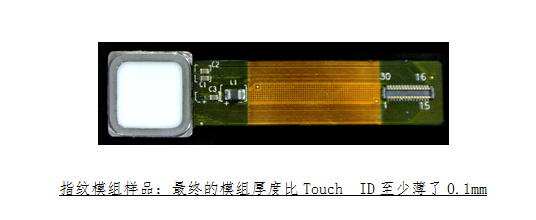
蘋果Touch ID采用的單晶氧化鋁磨厚度基本都在300um,再往下減薄將產生很多的技術問題,造成性價比難題,而華進半導體采用的氧化鋯陶瓷的硬度是8.5,單晶氧化鋁(藍寶石)是9,在耐磨性耐劃性上是等價的;而氧化鋯陶瓷的韌性高于單晶氧化鋁6倍以上,這意味著更高的抗沖擊抗震動能力;同時電學性能達到單晶氧化鋁3倍以上,是非常理想的材料。作為人造寶石級仿鉆的材料,其品味也不比人造藍寶石材料差。所以基于華進采用的TSV封裝方案結合客戶芯片的優秀算法可以把保護蓋板厚度降低至200um以下,這是節省整體模組的厚度關鍵所在。
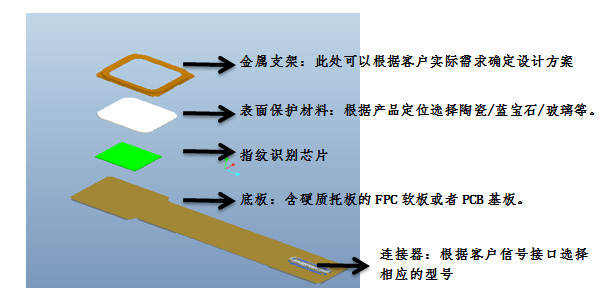
無論蘋果的1.2mm還是華進的超薄模組體,在保證機械強度的前提下,都是做到了極致。如果進一步降低厚度,則循環按壓壽命將嚴重降低。
從指紋識別整體制程角度看,華進半導體改良了設計和工藝,在現有的其他廠商模組設計的基礎上,把trench + wire bonding轉變為TSV + SMT,大幅度簡化結構,從而極大提高良率和產能。在行業進入爆發式增長階段時,將不受可制造性的限制,產能足以滿足市場需求。
華進半導體在指紋識別模組的設計標準中充分吸收了已有的指紋識別的優秀設計案例,并對其中不合理的部分進行了優化,從而在力學、電學、化學等方面均達到優秀水準。TSV的封裝,Sensor的高集成度,將模組部件精簡為5個,包括a. ring環; b.蓋板;c. TSV packaged sensor;d. FPC;e. 托盤,豎向同軸組裝,在小批量階段全制程良率已經超過80%,有望迅速向95%以上突破。
從指紋識別整體制程角度看,華進半導體改良了設計和工藝,在現有的其他廠商模組設計的基礎上,把trench + wire bonding轉變為TSV + SMT,大幅度簡化結構,從而極大提高良率和產能。在行業進入爆發式增長階段時,將不受可制造性的限制,產能足以滿足市場需求。
華進半導體在指紋識別模組的設計標準中充分吸收了已有的指紋識別的優秀設計案例,并對其中不合理的部分進行了優化,從而在力學、電學、化學等方面均達到優秀水準。TSV的封裝,Sensor的高集成度,將模組部件精簡為5個,包括a. ring環; b.蓋板;c. TSV packaged sensor;d. FPC;e. 托盤,豎向同軸組裝,在小批量階段全制程良率已經超過80%,有望迅速向95%以上突破。


 中文
中文
 English
English 蘇公網安備 32021402001899號
蘇公網安備 32021402001899號