服務范圍
1. 設計仿真服務:
電學仿真、熱管理和熱機械可靠性仿真、工藝仿真等。
2. 先進封裝設計加工服務:
8/12英寸晶圓級封裝工藝服務:Bumping、WLCSP、FOWLP、TSV、2.5D/3D。
SiP封裝、先進傳感器封裝、高速高密度封裝、高速高頻器件封裝、特種CIS封裝、三維封裝
基板生產:FCCSP 以及FCBGA 相對應的基板封裝服務,包含高密度基板、coreless基板、玻璃基板
3. 測試服務及可靠性失效分析服務:
3.1 電學測試:擁有先進的電學測試設備,可進行信號完整性、電源完整性、模擬、數字、RF、材料電學參數(損耗角、介電常數等)、EMI等電學性能的測試。
3.2 可靠性測試及失效分析:擁有熱沖擊/循環實驗箱、高速老化箱、DMA、TMA、TGA以及X-ray等先進的失效分析設備,主用于對基板、封裝進行溫、濕度循環實驗以及對失效封裝進行分析。
3.3 熱測試平臺:擁有微型壓縮機、壓力傳感器、熱電偶、冷凝劑、NI控制器、真空泵等熱測試設備
4. 工藝結構驗證服務:
華進可以提供如下規格的標準假片;如有其它需求,亦可定制。
| RDL | TSV | Bumping | Oxide Wafer | Cu Wafer |
RDL
規格書:
Item | Single Side RDL | Double Side RDL |
Min Si Thickness | 60um | 60um |
Copper Thickness | >6um | >6um |
Copper Line/Space | Min 10um/10um | Min 10um/10um |
Chip Size | Target ±20um | Target ±20um |
Min Chip Size | 0.6mm×0.3mm | 0.6mm×0.3mm |
Tape&Reel | Min die thickness 90um | Min die thickness 90um |
結構示意圖:
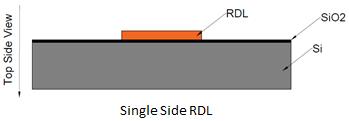
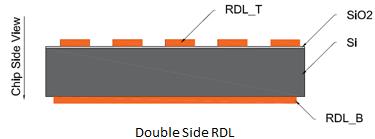
TSV
規格書:
Item | TSV 10:100 | TSV 20:200 |
Wafer size | 300mm | 300mm |
Si Thickness | 100um±10um | 200um±10um |
Via size | 10um±1.5um | 20um±3um |
Metal layers | Top side:3 | Top side:3 |
Copper Line/Space | Min 10um/10um | Min 10um/10um |
Micro Bump Pitch | Min 40um | Min 40um |
結構示意圖:
![]()
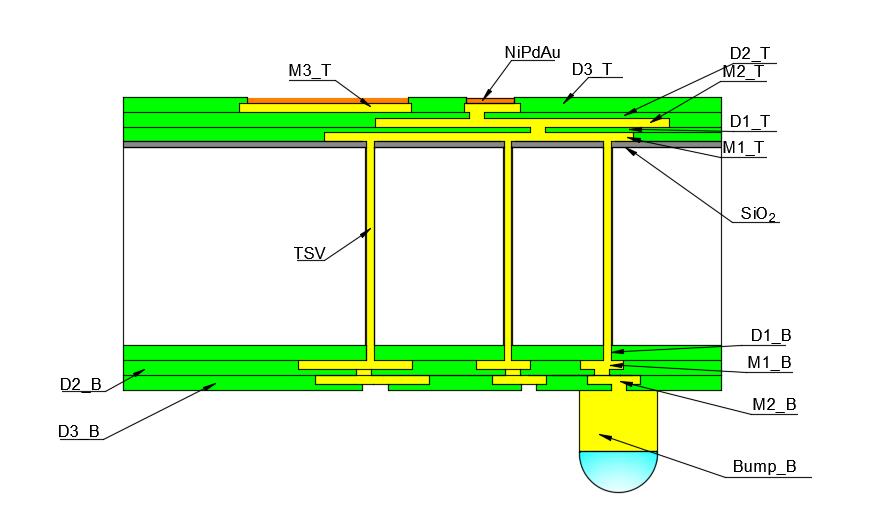
Bumping
規格書:
Item | Wafer Bumping |
Wafer Size | 300mm/200mm |
Bump Pitch | Min 80um |
Bump Size | Min 50um |
Bump Height | <80um |
RDL Line/Space | Min 10um/10um |
結構示意圖:
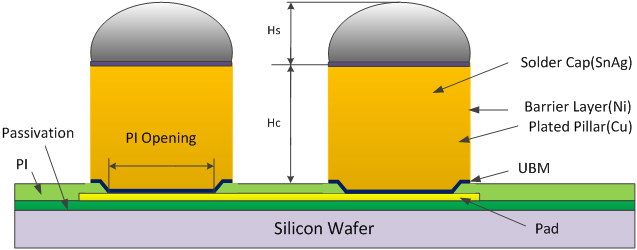
Oxide Wafer
規格書:
Item | Oxide Wafer | Oxide Wafer |
Wafer size | 300mm | 200mm |
SiO2 Thickness | 0.1um~6um | 0.1um~6um |
Cu Wafer
規格書:
Item | Cu Wafer | Cu Wafer |
Wafer size | 300mm | 200mm |
Cu Thickness | ≥1um | ≥1um |
5. 戰略調研與知識產權服務:
國際知名調研機構Yole Development公司中國區制定合作伙伴和代理,可提供先進封裝相關領域標準或定制調研報告。
依托公司知識產權服務平臺與專業技術團隊,可提供先進封裝相關領域知識產權調研、分析等服務。


 中文
中文
 English
English 蘇公網安備 32021402001899號
蘇公網安備 32021402001899號