SYNAPS 2021線上研討會成功舉辦
2021年5月18日-5月20日, SYNAPS 2021 線上研討會成功舉辦。本次研討會由華進和Yole共同主辦,由BESI、SPTS、ERS、KLA、VISITECH、ASM、KNS、北方華創、HANMI、JSR傾情贊助。
SYNAPS關注全球行業趨勢,為業界同仁提供了一個分享行業觀點、評估新興方案、開拓市場機遇的專業平臺。因疫情常態會,本次SYNAPS采用線上研討會的形式,是一場跨時空的云上技術交流會。會議共設三大議題,包括:異質集成、扇出&SIP、新型封裝。來自三星電子、SPTS、應用材料、BESI、KNS、華天、UTAC、Fraunhofer、通富微電、ERS、ASMPT、YOLE、華進、恩智浦、賀利氏、安森美、奧特斯、System Plus的十八位重量級嘉賓與會報告,與會觀眾熱情踴躍、積極提問,與現場嘉賓積極互動,呈現了一場半導體先進封裝的技術盛宴。
異質集成技術
5月18日的會議議題為異質集成技術,首先由三星電子向觀眾展示了先進晶圓級封裝解決方案,包括Chiplet、針對HPC\服務器\數據中心的2.5D和3D SiP封裝、混合鍵合技術以及ISC(集成堆疊電容)。華天科技為觀眾介紹了其倒裝技術及發展趨勢。SPTS、應用材料、BESI分別介紹了低溫高質量的PECVD、封裝互連工藝和設備以及針對異質集成的貼片解決方案;KNS則陳述了TCB工藝的挑戰并重點介紹了無助焊劑鍵合方案。

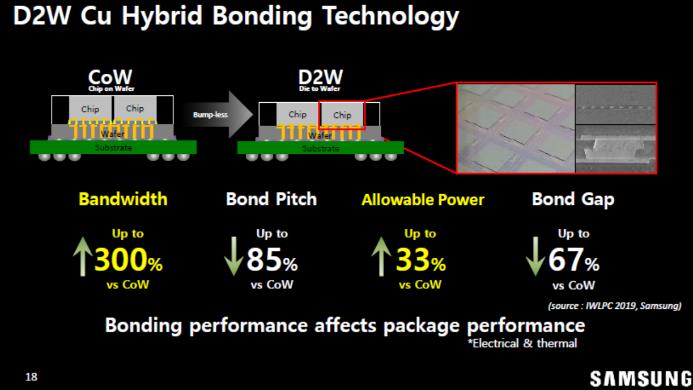
扇出&SIP技術
5月19日的會議主題為扇出&SIP技術,首先由UTAC作“助推半導體市場增長的第三次浪潮”的主題報告。報告認為針對5G毫米波、AI、AR/VR、云計算等關鍵技術融合正在醞釀之中,將推動下一代產品發展,并在未來十年實現2位數的增長率。隨后,Fraunhofer重點介紹了晶圓級和板級封裝的技術發展、不斷變化的生態系統和實際的業務場景。通富微電介紹了SiP的技術能力,并分享了FO SIP的工藝和產品性能挑戰。ASM、ERS展示了FOWLP中翹曲矯正和WLSIP的貼片解決方案。最后,Yole分享了扇出封裝的最新趨勢。


新型封裝技術
5月20日的會議議題為新型封裝技術。首先,恩智浦分享了以“針對自動駕駛的先進封裝”為主題的報告。報告認為自動駕駛技術的進步為許多行業帶來了巨大的商機,汽車電子封裝正發生改變以滿足更高的功能要求,半導體質量是自動駕駛技術成功的必要條件。賀利氏介紹了針對SMD和FC SIP應用的一體化印刷解決方案;安森美和華進半導體分別介紹了一種新型的針對TMPIM(Transfer Molded Power Integrated Moldule)的封裝方案和光電集成解決方案。奧特斯認為5G等應用趨勢推動了功能集成的需求,并推動技術為PCB帶來額外的功能,并展示了基于先進襯底技術的不同功能集成可能性。 最后System Plus分享了先進封裝技術趨勢,包括異質集成、混合鍵合和PoP。

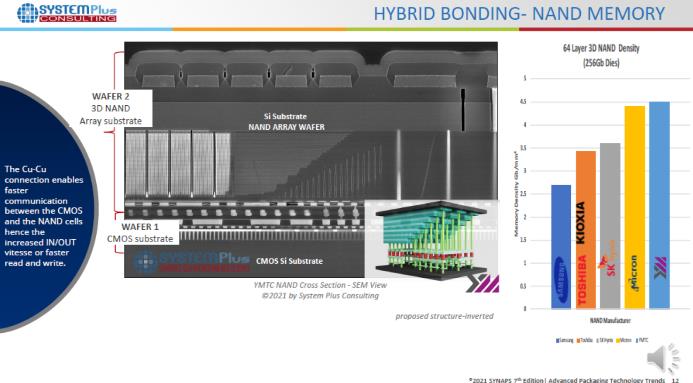
華進肩負著促進國內外產學研合作,推動中國集成電路產業做大做強的使命。SYNAPS是全球獨一無二的專注于先進封裝的技術交流平臺,更是業界企業和專家之間的獨特紐帶。經過多年積累,已成為行業認可的最專業的先進封裝技術交流平臺,獲得好評無數。本次活動吸引近百家半導體企業參會,聽會觀眾近200人,包括設計公司、OSAT、IDM、OEM、終端用戶、設備及材料供應商等,相信未來將有更多的半導體追夢人們在此相遇相知,帶著共同的信念為集成電路事業做出巨大貢獻。
(華進戰略部)


 中文
中文
 English
English 蘇公網安備 32021402001899號
蘇公網安備 32021402001899號