系統級封裝技術及市場趨勢(2020年版)
供應鏈管理是系統級封裝業務成敗的關鍵因素
近年來,隨著系統級封裝從低端應用(小尺寸、I/O數少)拓展至高端應用(大尺寸、I/O數多),其市場需求量顯著增加。
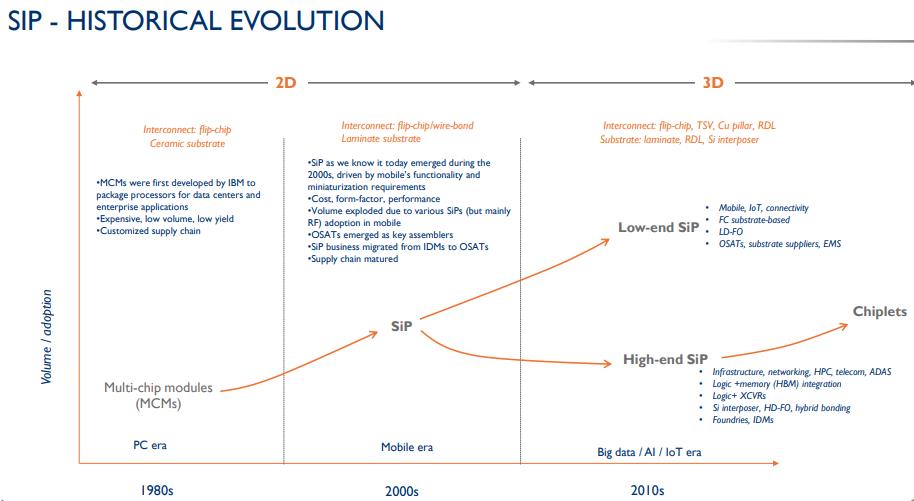
系統級封裝歷史演變
目前,制造商采用的商業模式是SiP成功與否的關鍵因素。也就是說,相對材料、技術、成本等典型的關鍵因素,商業模式對SiP的成功更為關鍵。SiP利用現有技術和基礎設施實現多顆芯片的封裝。但是,如果出現交付或者質量問題導致其中一顆芯片無法到位,整個SiP生產過程將被迫中斷。因此,SiP解決方案還需要組裝和測試能力。因此,對無晶圓廠和設計公司而言,能夠提供完整SiP服務的業務模式才是******制造選擇。
不幸的是,在目前的供應鏈環境中,現有的業務模式(晶圓代工廠、OSAT、基板制造商等)幾乎不可能建立一個完整的整體解決方案,必須轉換業務模式以獲得所需的功能。在SiP產業背景下,將涌現新的業務模式趨勢。Yole相信OSAT和晶圓代工廠都有潛力逐步提供整體解決方案。例如,代工廠能力正在向OSAT和基板制造商延伸,以獲得測試和組裝能力,即使在供應鏈終端出現良率問題時,也能保護自身利益。
在過去幾十年,原始設備制造商、電子制造服務廠商、晶圓代工廠、整合器件制造商和無晶圓廠都嚴重依賴于OSAT來領導或者聯合領導先進封裝技術的開發及升級。基于對SiP供應鏈的整體分析,Yole認為OSAT和代工廠業務模式的演變將成為有利趨勢,從戰略上保障了更多SiP業務。領先的OSAT可以通過良好的資本支出投資和并購,彌補缺少基板制造商和EMS能力的短板,從而實現完整的解決方案,以較低成本和協同設計的便利性來吸引無晶圓廠。同時,代工廠將管理與SiP相關的并購和資本支出,******化平衡SiP的質量和性能。
這份報告詳細分析了不同的先進封裝平臺供應鏈、SiP商業模式演變、相關廠商的戰略,商業化趨勢等等。

SiP供應鏈:商業模式演變
倒裝芯片和引線鍵合占主導地位,但扇出封裝和嵌入式芯片封裝機會充足
SiP具有多項優勢:封裝尺寸更小、性能更佳、集成電磁干擾屏蔽功能;和獨立封裝或SoC封裝相比,設計更靈活、成本更低。
目前,倒裝芯片和引線鍵合技術在高端和低端SiP應用、2D/2.5D/3D異構SiP中得到了廣泛應用。5G和連接性對尺寸、性能要求驅動低端SiP的發展,高端SiP則需要降低成本。隨著最近對先進大尺寸封裝需求的激增,制造商已經為倒裝芯片/引線鍵合SiP(FC & WB SiP)量身定制了一輪新投資浪潮。此外,OSAT的獨特性使其順利完成了重新定位,從而具備了為FC & WB SiP生態系統提供完整解決方案的能力。
倒裝芯片和引線鍵合SiP市場價值122億美元(占SiP封裝收入的90%以上),預計到2025年將達到171億美元,2019-2025年復合年增長率為6%。倒裝芯片和引線鍵合SiP率先為低端和高端應用創造價值,并在供應鏈中創造新的機遇。
扇出(FO)封裝已經成為SiP的主要封裝選項之一。然而,扇出封裝在SiP的應用仍然受限于多芯片工藝的良率成本問題。因此,目前正在開發和采用FO SiP技術的廠商已經具有很強的專業知識和成熟的量產能力。該市場自2017年以來一直由臺積電主導,2019年臺積電在FO SiP的市場份額超過90%。FO SiP的關鍵應用仍然是移動和消費類電子。然而,隨著數據中心、5G和自動駕駛的興起,將推動FO SiP在電信、基礎設施和汽車等方面的應用。
嵌入式芯片技術正從單芯片嵌入過渡至多芯片嵌入。IC基板和電路板的復雜性增強、尺寸變大,因為平均銷售價格(對于特定市場的某些應用來說)將有所增長。在2019-2025年期間,嵌入式芯片SiP的出貨量增長率將達27%左右,2025年其市場規模將超過3.15億美元,主要來源于汽車、電信&基礎設施、移動應用。盡管嵌入式芯片SiP市場規模很小,但是增長勢頭強勁。
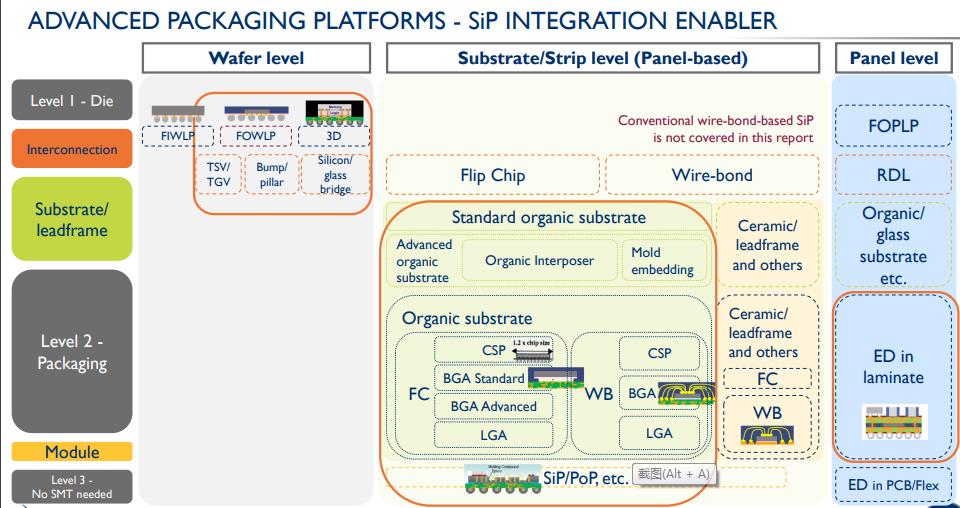
先進封裝平臺——SiP集成賦能者
本報告針對不同封裝平臺,覆蓋各類應用,聚焦SiP技術趨勢、發展路線圖、市場驅動因素、技術挑戰以及市場現狀等。
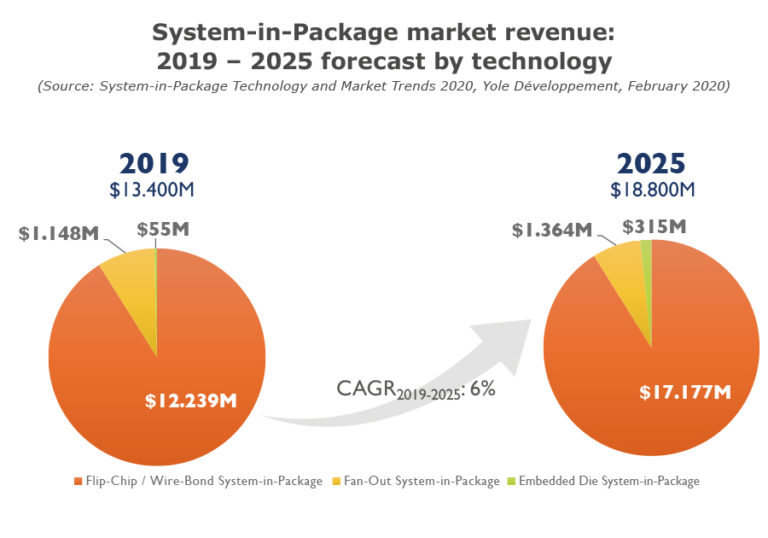
2019-2025年SiP市場規模(技術細分)
在各類應用對異質集成的需求驅動下,2025年SiP業務規模將突破190億美元。
5G、連接性、網絡、服務器和物聯網等大趨勢對SiP的需求越來越多,制造商的業務模式不斷更新,SoC先進硅技術節點對成本的關注日益增加,封裝技術的飛躍發展等一些列因素都將推動SiP市場的增長。
2019年SiP市場實現了134億美元的營收,復合年增長率達6%,2025年市場規模將實現188億美元。移動和消費類電子是SiP的******市場(復合年增長率5%),緊隨其后的是電信和基礎設施(復合年增長率11%)和汽車市場(復合年增長率11%)。這些數據并不令人驚訝,作為新興封裝技術的先驅者,對上述市場而言,減少封裝尺寸和提高性能是關鍵參數。
在移動和消費電子領域,手機占SiP 2019年市場******份額。不過,增長最快的動力來自市場規模較小的其他終端設備。未來五年,未來5年,可穿戴設備、Wi-Fi路由器和物聯網將在SiP市場快速增長,主要驅動因素是5G和傳感器。盡管手機(尤其是智能手機)市場已經飽和,隨著步入5G時代,為SiP創造了新的機會。在電信和基礎設施領域,基站和服務器的復合年增長率都有望達到兩位數,其中基站的年復合增長率高達41%。這主要是因為5G基站需要通過倒裝芯片球柵陣列實現更多SiP集成。此外,服務器如CPU、 xPU(小芯片、硅轉接板、扇出型)和現場可編程門陣列需要高端SiP。
在汽車和運輸行業,高級駕駛輔助系統和資訊娛樂是主要驅動力。盡管攝像頭的市場份額很小,但是ADAS的單目、雙目和三目攝像頭都將采用SiP,因此其增速最快。此外,視覺處理單元和資訊娛樂對計算能力也有要求。SiP的另一驅動力來自于MEMS和傳感器,包括壓力傳感器、慣性測量單元、光學MEMS、微測輻射熱計、振蕩器和環境傳感器等。醫療、工業、國防和航空航天等領域的SiP市場規模尚小,但在機器人和物聯網相關應用中,其增速強勁。
本報告針對不同封裝平臺和不同應用,發布了2018年-2025年SiP市場預測,并對相關廠商及其市場份額進行分析。

2019年SiP市場份額

2019-2025年SiP市場規模預測(應用細分)
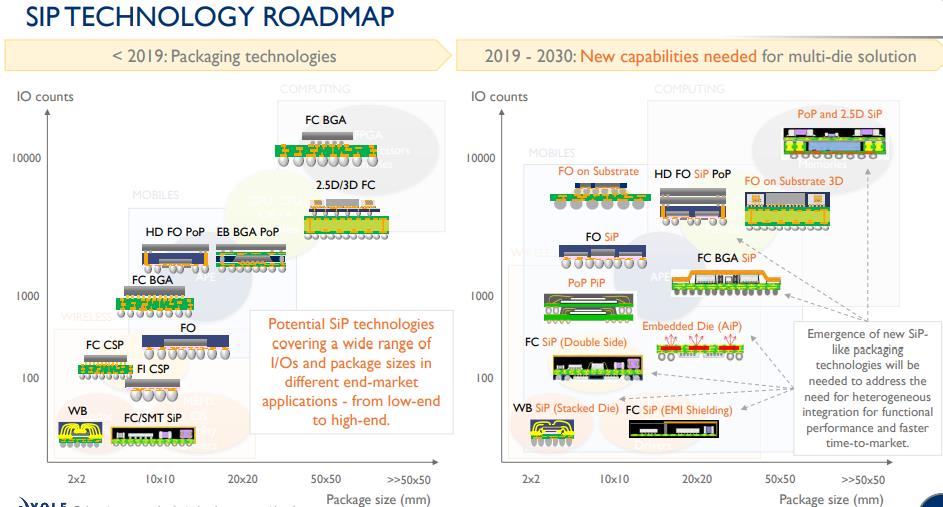
SiP技術路線圖
關于《System-in-Package Technology and Market Trends 2020》
本報告共計330頁,探索了先進封裝領域的最熱趨勢,包括SiP市場預測(主要關注FC,WB,FO和ED)和市場發展趨勢、市場份額以及整體產業鏈分析。
報告涉及的企業
Access, Amkor, Analog Devices, Apple, ARM, ASE, Avago, AT&S, Bosch, Broadcom, Carsem, China WLCSP, Chipbond, ChipMOS, Cisco, Continental, Cyntec, Cypress Semiconductor, Deca Technologies, Dyconex, Facebook, Fitbit, Flexceed, Flip Chip International, Formosa, Fraunhofer IZM, Freescale, Fujikura, Fujitsu, GaN Systems, General Electric, GlobalFoundries, Google, Hana Micron, Hella, Huawei, IMEC, Inari Berhad, Infineon, Intel, J-Devices, JCET, King Yuan, Lenovo, Linear Technology, LB Semicon, MediaTek, Medtronic, Meiko, Microchip, Microsemi, Nanium, Nepes, Nvidia, NXP, Nokia, ON Semiconductor, Orient Semiconductor, Powertech Technology Inc, Renesas, QDOS, Qorvo, Qualcomm, Rohm, Sarda Technologies, Samsung Electronics, SCC, Schweizer, SEMCO, SIMMTECH, SK Hynix, Shinko, ShunSin, SiPlus, Softbank, SONY, SPIL, Spreadtrum, STMicroelectronics, STATS ChipPAC, STS Semiconductor, Taiyo Yuden, TDK, Teraprobe, Texas Instruments, Tianshui Huatian, Tongfu Microelectronics, Tong Hsing, Toshiba, TSMC, Unimicron, Unisem, USI, UTAC, Wurth Electronics, and many more…
相關報告
《先進封裝市場現狀 (2019版)》
《扇出封裝技術和市場現狀(2019版)》
《手機應用的先進射頻SiP封裝(2019版)》
《先進封裝市場季度報告》-新產品
《扇出封裝工藝對比(2020版)》
購買方式
如需樣刊或購買報告,請聯系華進戰略部:0510-66679351 Xiaoyunzhang@ncap-cn.com
以上圖文譯自Yole Développement的(x)PU: High-End CPU and GPU for Datacenter Applications 2020
原文請參考:https://www.i-micronews.com/products/xpu-high-end-cpu-and-gpu-for-datacenter-applications-2020/

關于華進
華進半導體于2012年9月在無錫新區正式注冊成立,開展系統級封裝/集成先導技術研究,研發2.5D/3D TSV互連及集成關鍵技術(包括TSV制造、凸點制造、TSV背露、芯片堆疊等),為產業界提供系統解決方案;同時開展多種晶圓級高密度封裝工藝與SiP產品應用的研發,以及與封裝技術相關的材料和設備的驗證與研發。
微信:NCAP-CN



 中文
中文
 English
English 蘇公網安備 32021402001899號
蘇公網安備 32021402001899號