封裝設(shè)計(jì)
Design & Simulation Capability
Item | Package Design | Electrical Simulation | Thermal Management | Mechanical Analysis |
1 | FC/WB BGA Design | Impedance matching and control | Thermal design and verification | Process simulation (Molding, Reflow, etc.) |
2 | MCM /SiP Design | Lumped parameter elements extraction | Thermo-electrical co-simulation | Thermo-mechanical simulation (TC, HTS) |
3 | WLCSP / Fan out WLP design | S parameters extraction | Hot spot effect evaluation | Humidity simulation |
4 | PoP/PiP design | TDR analysis | Thermal resistance extraction | Hygro-mechanical simulation |
5 | FPC design | SI/PI analysis | - | Thermo-mechanical-moisture simulation (HAST, 85°C/85RH, etc.) |
6 | 2.5D Interposer Design | EMI analysis | - | Drop test |
7 | Ceramic Design | IPD simulation | - | - |
8 | IPD Design | RF/MW System simulation | - | - |
高密度SiP設(shè)計(jì)方案
研究領(lǐng)域:
高密度SiP封裝, 最高引腳數(shù)1W+;
高頻器件, 封裝支持最高頻率100GHz以上;
先進(jìn)封裝, Fanout, 2.5 Interposer,C2C鍵合、W2W鍵合 、硅基3D封裝;
| 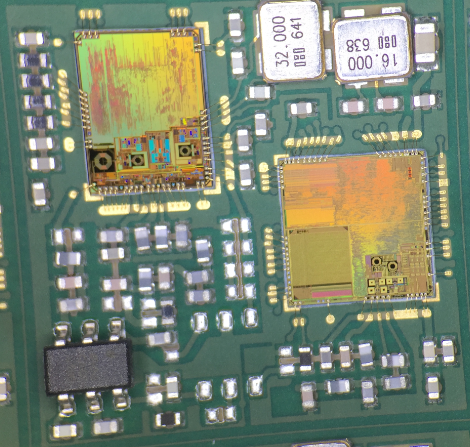 |  |
| FC+WB SiP樣品 | 高功率SiP樣品 | |
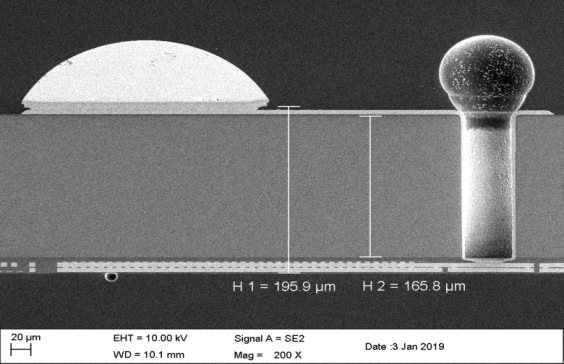 | 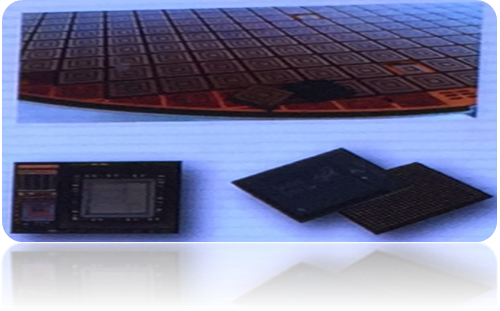 | |
| 硅基3D封裝 | CIS封裝 | Fan-out封裝 |


 中文
中文
 English
English

 蘇公網(wǎng)安備 32021402001899號(hào)
蘇公網(wǎng)安備 32021402001899號(hào)